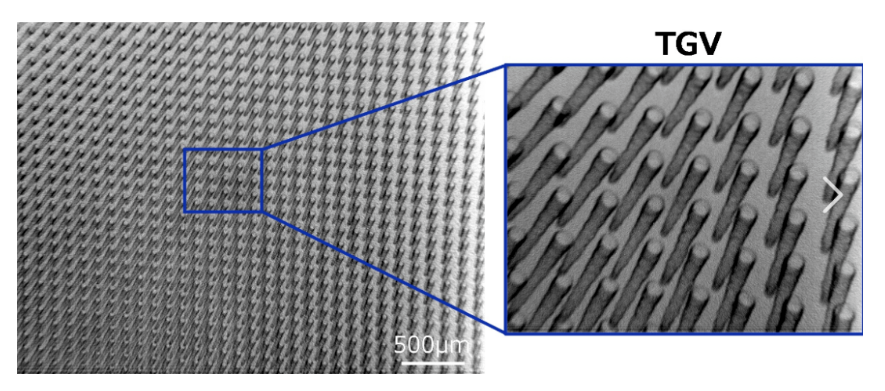
Hvad er TGV?
TGV (Gennemgående glas via), en teknologi til at skabe gennemgående huller på et glassubstrat. Kort sagt er TGV en højhusbygning, der stanser, fylder og forbinder op og ned ad glasset for at bygge integrerede kredsløb på glasgulvet. Denne teknologi betragtes som en nøgleteknologi til den næste generation af 3D-emballage.

Hvad er TGV'ens karakteristika?
1. Struktur: TGV er et vertikalt penetrerende ledende gennemgående hul lavet på et glassubstrat. Ved at aflejre et ledende metallag på porevæggen forbindes de øvre og nedre lag af elektriske signaler sammen.
2. Fremstillingsproces: TGV-fremstilling omfatter forbehandling af substrat, hulfremstilling, aflejring af metallag, hulfyldning og udfladning. Almindelige fremstillingsmetoder er kemisk ætsning, laserboring, galvanisering osv.
3. Anvendelsesfordele: Sammenlignet med traditionelle metalgennemføringer har TGV fordelene ved mindre størrelse, højere ledningstæthed, bedre varmeafledningsevne osv. Udbredt anvendt inden for mikroelektronik, optoelektronik, MEMS og andre områder med højdensitetsforbindelse.
4. Udviklingstendens: Med udviklingen af elektroniske produkter mod miniaturisering og høj integration får TGV-teknologi mere og mere opmærksomhed og anvendelse. I fremtiden vil fremstillingsprocessen fortsat blive optimeret, og dens størrelse og ydeevne vil fortsat forbedres.
Hvad er TGV-processen?
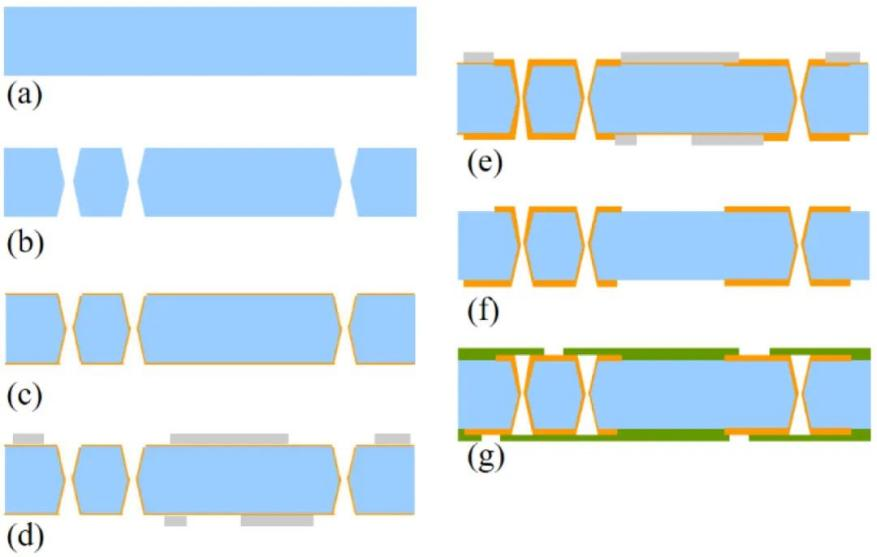
1. Forberedelse af glassubstrat (a): Forbered et glassubstrat fra starten for at sikre, at dets overflade er glat og ren.
2. Glasboring (b): En laser bruges til at danne et penetrationshul i glassubstratet. Hullets form er generelt konisk, og efter laserbehandling på den ene side vendes det og bearbejdes på den anden side.
3. Metallisering af hulvæggen (c): Metallisering udføres på hulvæggen, normalt gennem PVD, CVD og andre processer, for at danne et ledende metalkimlag på hulvæggen, såsom Ti/Cu, Cr/Cu osv.
4. Litografi (d): Glassubstratets overflade belægges med fotoresist og fotomønstres. Eksponer de dele, der ikke skal pletteres, så kun de dele, der skal pletteres, eksponeres.
5. Hulfyldning (e): Elektroplettering af kobber for at fylde glassets gennemgående huller for at danne en komplet ledende bane. Det kræves generelt, at hullet er fuldstændigt fyldt uden huller. Bemærk, at Cu i diagrammet ikke er fuldt udfyldt.
6. Flad overflade af substratet (f): Nogle TGV-processer vil flade overfladen af det fyldte glassubstrat ud for at sikre, at substratets overflade er glat, hvilket er befordrende for de efterfølgende procestrin.
7. Beskyttelseslag og terminalforbindelse (g): Et beskyttende lag (såsom polyimid) dannes på overfladen af glassubstratet.
Kort sagt, hvert trin i TGV-processen er kritisk og kræver præcis kontrol og optimering. Vi tilbyder i øjeblikket TGV-gennemføringsteknologi i glas, hvis det er nødvendigt. Kontakt os venligst!
(Ovenstående oplysninger er fra internettet, under censurering)
Opslagstidspunkt: 25. juni 2024
